반도체 유리기판 생태계를 선점하기 위해 일본 메이저들이 신소개 개발 경쟁을 벌이고 있다.
인텔(Intel)은 2023년 2020년대 후반 유리기판을 채용한다고 발표했다. 실리콘(Si) 칩과 유리(SiO2) 코어는 열팽장계수가 비슷해 기판 전체의 왜곡과 뒤틀림을 제어하기 용이하다.
글로벌 메이저가 플래스틱기판에서 유리기판으로 전환을 검토함에 따라 빌드업 필름에도 새로운 스펙이 요구될 것으로 예상되며 인터포저(Interposer) 역시 플래스틱, 유리화 움직임이 활발해지고 있다.
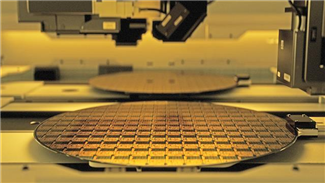 AGC는 유리코어를 새로운 사업으로 평가하고 개발을 본격화하고 있으며, DNP는 이미 TGV(유리관통전극) 유리코어 개발을 완료했다.
AGC는 유리코어를 새로운 사업으로 평가하고 개발을 본격화하고 있으며, DNP는 이미 TGV(유리관통전극) 유리코어 개발을 완료했다.
NEG(Nippon Electric Glass)는 최근 세라믹의 특성을 겸비해 고속에서 크랙 없이 천공 가공이 가능한 유리 세라믹 코어기판 GC Core를 개발한 것으로 알려졌다.
반면, 2.5D 및 로직용 FC(Flip Chip)-BGA(Ball Grid Array) 기판 소재 메이저 레조낙(Resonac)은 유리기판용 표면처리제 개발을 비롯해 유리 시대의 니즈에 대응하는 동시에 플래스틱 코어를 유리코어에 대항 가능하도록 강화하는 전략을 추진한다.
그러나 스마트폰용 AP(어플리케이션 프로세서)와 메모리 등에 사용하는 FC-CSP(Chip Scale Package) 기판 소재 1위 MGC(Mitsubishi Gas Chemical)가 FC-BGA 시장에 진출해 채용을 확대하는 등 레조낙을 압박하고 있다.
MGC는 유리기판은 하이엔드 반도체에 적용되고 플래스틱기판은 볼륨존을 차지하게 될 것으로 예상하고 플래스틱기판 시장을 흡수해 지속적인 성장을 추구할 계획이다.
빌드업 필름은 현재 아지노모토(Ajinomoto)의 ABF가 사실상 표준을 형성하고 있으나 최근 LG화학이 시장 확대를 예상하고 개발을 추진하고 있는 것으로 알려졌다.
MGC 역시 프리프레그 기술을 응용한 빌드업 필름을 제안하고 있으며 다이요(Taiyo)는 로직용 솔더 레지스트 확대와 함께 빌드업 필름 신규 채용을 추진하고 있다.
인터포저는 실리콘보다 코스트를 낮출 수 있는 플래스틱 RDL(재배선층) 채용이 예상된다.
액상 감광성 절연막을 영구막으로 사용하는 패턴이 일반적이나 필름 타입을 이용할 가능성도 있다. 레조낙은 최근 선폭 1마이크로미터에 필름타입으로 대응하는데 성공해 2024년부터 샘플 공급을 시작할 예정이다.
유리 인터포저도 플래스틱 인터포저와 마찬가지로 패널 사이즈로 생산할 수 있어 코스트를 낮출 수 있다.
NEG와 DNP 등이 개발을 추진하고 있으며, 라피더스(Rapidus)도 성능과 코스트 밸런스가 우수하고 실리콘과 유기 소재의 좋은 점을 겸비한 것으로 판단하고 칩렛 분야에서 채용을 추진하는 것으로 알려졌다. (윤)





















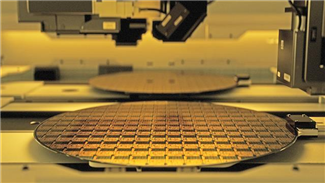 AGC는 유리코어를 새로운 사업으로 평가하고 개발을 본격화하고 있으며, DNP는 이미 TGV(유리관통전극) 유리코어 개발을 완료했다.
AGC는 유리코어를 새로운 사업으로 평가하고 개발을 본격화하고 있으며, DNP는 이미 TGV(유리관통전극) 유리코어 개발을 완료했다.
